
在过去的十年中,电子产品运算工作负载的发展可能要比过去的四十年还要来得多。就在不久之前,即使是世界上最先进的处理器一般负责的工作也不过是文字处理、电子表格、简报图表,偶尔再玩玩接龙纸牌游戏而已。
时间快转到2020年,今日的运算应用和工作负载比过往的数十年更加多元,对效能的要求也更高。云端运算、大数据分析、人工智能(AI)神经网络训练、人工智能推理,高端智能型手机或甚至是自动驾驶汽车上的行动运算都在推动运算领域的发展。为了因应这些新的工作负载,内存效能和功耗效率在产品设计中也变得更为至关重要。
那么,这些运算趋势和工作负载与封装技术有什么关联呢?不久之前,封装技术还只被视为产品芯片的后端制程。但是时代已经改变,工作负载的发展将封装技术推向了创新的最前沿,而它们对于产品的效能、功能和成本至关重要。
这些现代的工作负载促使产品设计采用更全面的方法来在系统级别进行优化。如果没有当今的先进封装,某些产品就无法达到技术或商业上的可行性。
TSMC的3DFabric先进封装技术系列,包含了TSMC全面的前端3D硅堆栈和后端先进封装技术,3DFabric和TSMC先进的半导体制程技术能够发挥相辅相成的效果,以协助客户在产品设计上可以不断创新。
TSMC的客户对如何解决新的运算问题有独特的见解,3DFabric为我们的客户提供了产品设计的最大弹性。对于产品架构师而言,单晶粒仍然是可行的选择,但在某些情况下,它不再是唯一的选择,甚至不再是理想的选择。3DFabric为我们的客户提供了自由和优势,使他们可以更全面地以微型芯片系统SIP的方式设计其产品,以提供相对于设计较大单晶粒的关键优势:
上市时间:客户可以将宝贵的开发资源和时间集中在运用最先进的TSMC半导体制程,设计出更快、功能更强大的运算核心,同时将技术模块重新使用于成本效益更高且不会频繁改变或扩大规模的成熟半导体制程,这么做可以加快创新速度,并缩短新产品的上市时间。
效能和效率:3DFabric提供了将高阶逻辑芯片和高速内存整合到封装模块中的选项。高带宽内存(HBM)的延迟和带宽优势是众所周知的,但鲜为人知的是其在电源效率方面的提升。在一定的带宽之下,HBM较宽的接口允许它以相对于较窄内存类型而言较低的频率速度运转,从而降低了功耗。就数据中心的规模而言,逻辑和HBM整合所能节省的成本相当可观。
尺寸外观:3DFabric还为HPC、智能型手机和物联网边缘装置提供了外形设计的优势。3DFabric允许我们的客户以更密集的2D、2.5D或3D互连配置将运算核心与异构微型芯片或小芯片整合在一起,从而大幅缩小了组件和主板的尺寸,并实现具有更强功能的尖端工业设计。
成本:客户可以在更成熟,成本更低的半导体制程上重新使用那些不会经常更改或扩展的模块,例如模拟/输入输出/射频技术。客户可以专注于那些可以在TSMC最先进的半导体制程上扩展的逻辑设计,并使用3DFabric将其与特殊制程小芯片整合到单一产品当中。
3DFabric技术系列包括2D和3D前端和后端互连技术。我们的前端技术或称TSMC-SoIC™(整合芯片系统)使用3D硅堆栈所需,并来自我们领先硅晶圆厂的精度和方法。 这些技术包括我们的CoW和WoW堆栈技术,其能让相似和不同芯片的3D堆栈提供以下功能:
- 通过增加运算核心数量来提高运算能力
- 堆栈式内存可提供更多内存和更高的带宽
- 通过深沟式电容改善功率传输,适用于大功率应用
TSMC拥有多个专属的后端晶圆厂,这些晶圆厂可以组装和测试包括3D堆栈芯片在内的硅芯片,并将其加工成封装后的装置。台积公司3DFabric的后端制程包括CoWoS和InFO系列的封装技术。
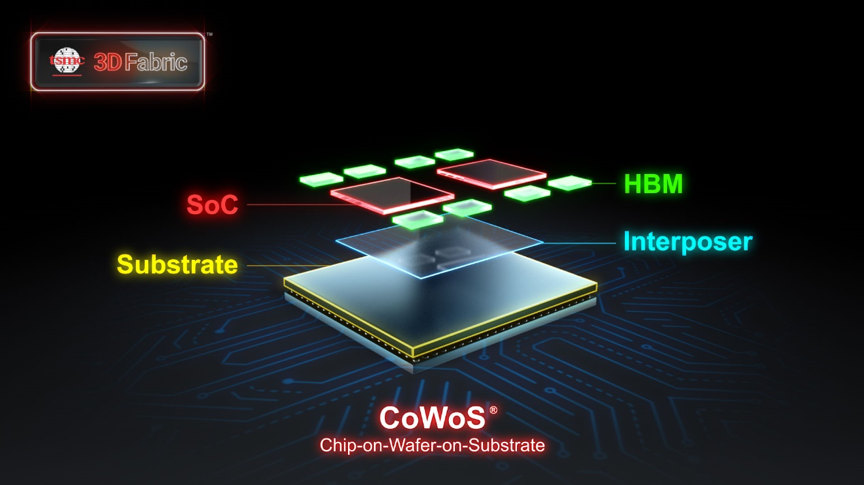

随着工作负载的变化,半导体制造和封装技术必须齐头并进发展,这些工作负载要求对产品设计采用全方位的系统级方案,以提高效能、电源效率、成本、外观尺寸和上市时间。3DFabric技术系列旨在为我们的客户提供强大而灵活的互连性和先进的封装技术,以释放他们的创新。

